电话:86-0755-23229824
手机:18948346937 / 13510373651
邮箱:sales@lisenoptics.com
地址:深圳市光明区华强生态科技园四期8栋B座2单元805室
微信:
微信客服号:
抖音官方号:
薄膜测量解决方案
薄膜是沉积在另一种物质表面的非常薄的物质层,广泛应用于技术工艺行业,如钝化绝缘层、防扩散层、硬涂层等。集成电路就主要由薄膜的沉积和选择性的去除组成。
随着信息产业的发展进步,光学薄膜的市场需求持续增长,同时对器件的特性要求也日益严格。物理厚度作为薄膜最基本的参数之一,对整个器件的最终性能具有重要影响。因此,快速而精确地测量薄膜厚度具有重要的实际意义。
一、薄膜测量原理
由于光学测量方法准确,无破坏,只需很少或无需专门样品,光学测量法常常是薄膜测量的首选方法。传统的测量薄膜物理厚度的光学方法主要有光度法和椭偏法两种。其中光度法是通过拟合分光光度计测得的透/反射率曲线来得到光学薄膜厚度的一种方法,但它要求膜层较厚以产生一定的干涉振荡并且只能测量弱吸收膜;椭偏仪测量具有灵敏度高的优点,但是受界面层等因素的影响,需要复杂的数学模型来求解厚度,上述方法已经成功而广泛地应用在各个领域。然而,随着近年来微光机电系统等微加工技术的发展,经常需要在高低起伏的基板上(patterned substrate)沉积薄膜,因此用测量表面轮廓的白光干涉仪来进行薄膜厚度测试的方法引起了人们的关注。

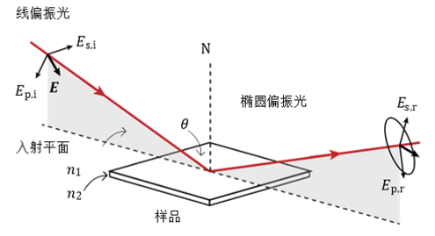
椭圆偏振仪的基本原理
光学测量是通过精确测量薄膜与光线的相互作用来获取薄膜特性的技术。这些特性包括薄膜的厚度、表面粗糙度以及光学常数等。光学常数是一个重要的物理参数,用于描述光在通过某种物质时如何传播和反射。这些常数可以提供有关材料光学性质的重要信息,例如折射率、消光系数和介电常数等。
通过光学测量,我们可以将这些光学常数与其他材料参数(如成分和带隙)相关联。例如,对于一种特定类型的半导体材料,其光学常数可以揭示其带隙宽度,这是决定其电子和光学性能的关键参数。
光学常数(n和k)描述光如何通过薄膜传播。在某个时间光穿过一种物质的电磁场可以简单表示为

其中x:距离,λ:光波长,n和k:薄膜相应的折射率和消光系数。折射率是光在物质和真空中传播速度的比值。消光系数是测量光在物质中被吸收了多少。
n 双缝干涉实验
光的干涉是指两列或两列以上的光波在空间中重叠时,由于频率相同、相位差恒定,使得某些区域的光强相互加强,某些区域的光强相互减弱,从而出现干涉现象。

杨氏双缝干涉实验是一种经典的物理实验,用于研究光的波动性质。光源发出的光通过两条狭缝,形成了两束相干光波,它们在屏幕上产生干涉图案。当两束光波的波峰或波谷恰好相遇时,它们会产生加强的干涉,形成明亮的条纹。相反,当一个波峰遇到一个波谷时,它们会产生相消干涉,形成暗条纹。这些干涉图案展示了光的波动性质。

光程差为

可以得到相位差为

干涉条纹的形状,即等强度线是一组纵向(即与纸面垂直)的平行直线。干涉条纹的间距△x定义为两条相邻亮纹(强度极大)或两条暗纹(强度极小) 之间的距离。单色光的干涉条纹宽度相同,明暗相间,均匀分布。不同色光条纹宽度不同,波长越长的干涉条纹的宽度越大。
光纤光谱仪实现薄膜厚度测量
当入射光穿透不同物质的界面时将会有部分的光被反射,由于光的波动性导致从多个界面的反射光彼此干涉,这两部分反射光可能干涉相长(强度相加)或干涉相消(强度相减),这取决于它们的相位关系。而相位关系取决于这两部分反射光的光程差,光程差又是由薄膜厚度、光学常数和光波长决定的。

薄膜厚度测量原理示意图
薄膜测量系统是基于白光干涉的原理来确定光学薄膜的厚度。白光干涉图样通过数学函数的计算得出薄膜厚度。对于单层膜来说,如果已知薄膜介质的n和k值就可以计算出它的物理厚度。
如下图为光镀有折射率为η膜层折射率为n1的基板光路示意图,在折射率为n1的基板上镀有复数折射率η为厚度为d的一层薄膜,放在折射率为n0的空间。假定薄膜的复数折射率η=n1+ik,当一光以幅度A从n0空间垂直入射(θ=0)到膜表面时(为便于分析,图中入射光有一定角度,实际测量中此角度一般很小,对测量的影响可以忽略不计),由于多次反射,在膜上表面有一系列的反射光。
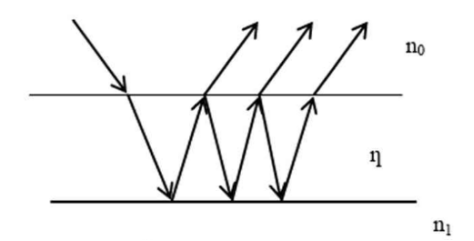
光镀有折射率为η膜层折射率为n1的基板光路示意图
使用光纤光谱仪测量薄膜的厚度主要是通过反射光谱,反射光谱曲线中干涉峰的出现是薄膜干涉的结果。
二、应用领域
薄膜测量解决方案可实现基本上所有光滑的、半透明的或低吸收系数的薄膜的测绘,如光刻胶、氧化物、硅或者其他半导体膜、有机薄膜、导电透明薄膜等膜厚精确测量,被广泛应用于半导体、微电子、生物医学等领域。
l 半导体领域:GaN涂层、SiO2、光刻胶、SOI等
l 显示面板领域:涂布厚度检测等
l 精密光学领域:二氧化硅膜、氟化钙膜等
l 聚合物薄膜、PET、PC、亚克力等
l 光学镀膜:硬涂层、抗反射层等


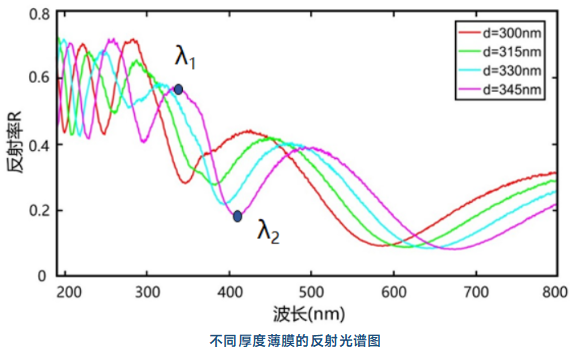
三、薄膜测量
为了实现设计功能,薄膜必须有合适的厚度,成分,粗糙度,和特定应用的其他重要特性。这些特性往往需要在薄膜的制造过程之中或之后测量。光学和探针测量是薄膜测量的两种主要类型。
基于白光干涉理论,利用莱森光学光纤光谱仪可以实现薄膜的高精度测量。这种测量方法通过正角度入射的反射率来获取薄膜的厚度和折射率信息,并通过提取光入射薄膜前后的相位变化来进行计算。相比传统的光度法和偏法,这种测量方法具有更高的精度和更快的测量速度,同时结构简单、成本低廉,为光学薄膜厚度的测量提供了一种简便、快速且可靠的解决方案。
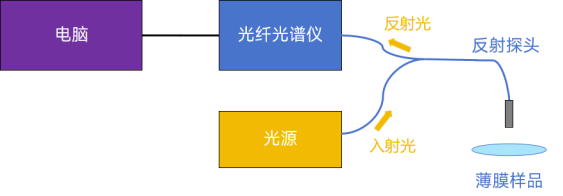
光纤光谱仪薄膜测量原理示意图
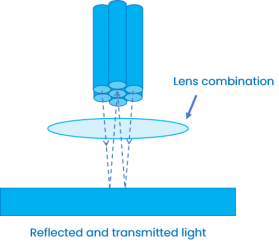
反射探头光路图
光纤光谱仪测薄膜厚度的优点:
l 高速度的数据采集:光纤光谱仪可以实现快速地搜集样品数据,使得其非常适合用于在线实时测量。这大大提高了测量效率,并能及时提供所需的数据。
l 非接触式光学测量:这种测量方式不会对样品造成任何损耗,从而保证了样品的完整性。这在对那些难以接触或易损坏的样品进行测量时显得尤为重要。
l 紧凑的尺寸和轻便的重量:光纤光谱仪的系统体积小,重量轻,使得其测量非常灵活。通过USB连接方式,可以实现即插即用的便捷性。
l 可定制的波段选择:用户可以根据自己的需求,定制不同波段的光谱仪。这大大提高了仪器的适应性,使其能够满足各种不同的测量需求。
l 可测量多层膜厚:光纤光谱仪不仅可以测量单层薄膜的厚度,还可以同时测量多层膜的厚度。这使得其在多层膜材料的测量中具有显著的优势。

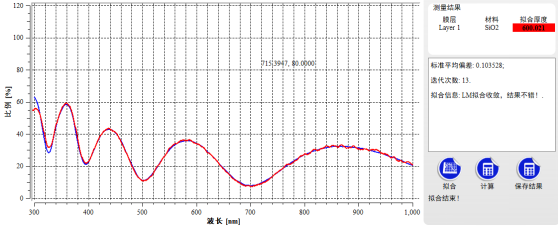
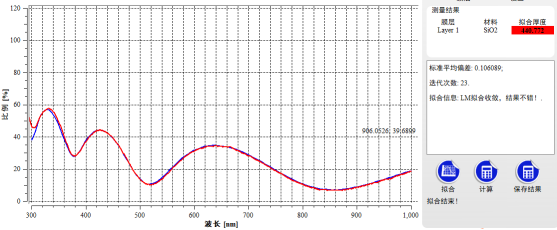
半导体硅片膜厚测试
测量软件
对于LiSpecView软件目前只能够实现薄膜的厚度测量,所有需要预先知道材料的光学参数(NK值)。
1) 测量材料:测量所有半透明薄膜,透明或则不透明的半导体材料。
2) 薄膜厚度范围:测量薄膜厚度范围依赖于材料和光谱仪配置。理论上估计可以实现1nm-1mm测量。
3) 测量薄膜层数:一般情况下使用为1-3层;有一些条件下应该可以测量到12层。对于大于3层薄膜的厚度测量的精确度需要进行评估。
4) 基底材料:基底材料表面的粗糙度限制最小测量膜厚。
5) 必备信息:膜层的顺序,材质,光学参数(NK值)。


不同膜层厚度,对应的光谱仪配置不同(波长范围和分辨率)及光源的选择不同
膜层厚度 | 波长范围 | 分辨率 | 光源 |
1nm-100nm | 200-1100 | 8nm | 氘卤灯 |
100nm-3um | 380-1100nm | 8nm | 卤素灯 |
10um-100um | 380-1100nm | ~1nm* | 卤素灯 |
10um-250um | 1000-1700nm | ~3-5nm* | 卤素灯 |
*依赖于测量的材料。
当我们对物体进行透射测量时,光谱仪等配件选择的重要性不可小觑。整套解决方案的每个部分都和测量结果的可靠性和准确性密切相关。接下来我们就透射测量解决方案(光谱配件、探头等等)进行详细分析。
Ø 光源:
iLight-HAL、iLight-HAL-HP、iLight-HAL-UV卤钨灯
iLight-DH-ADJ 氚卤组合光源
iLight-Xe 氙灯

Ø 光纤:
采用纯度很高的进口石英纤芯,光纤类型采用多模光纤,数值孔径为0.22,也可以为用户提供如NA=0.12、0.15/0.26/0.37等数值孔径的多模光纤

Ø 光谱仪:
使用时可根据待测光源的发光强度强弱配置LiSpec-UV100、LiSpec-HS400、LiSpec-HSR100-TEC系列的光谱仪,莱森光学的光谱仪拥有独有降噪低噪声电路控制技术,光谱仪暗噪声极低,具有优良的稳定性和高信噪比。
